
Проектирование интегральных микросхем и микропроцессоров
для специальности 220500
Кафедра КИБЭВС
Торгонский Л.А.
Томск-2006
№ 1
Изделие, элементы конструкции которого методами групповой технологии выполнены в объёме и (или) на поверхности полупроводниковой пластины-подложки, называется:
• кристаллом;
• полупроводниковой конструкцией.
№ 2
- выполнены на поверхности диэлектрической платы-подложки называется:
• платой;
• плёночной конструкцией;
• тонкоплёночной конструкцией;
• толстоплёночной конструкцией.
№ 3
- выполнены на поверхности диэлектрической платы-подложки плёнками толщиной менее 1 мкм, называется:
• платой;
• плёночной конструкцией;
• тонкоплёночной конструкцией.
№ 4
- выполнены на поверхности диэлектрической платы-подложки плёнками толщиной более 10-20 мкм, называется:
• платой;
• плёночной платой;
• толстоплёночной платой.
№ 5
Микроэлектронное изделие, выполняющее определенную функцию преобразования и обработки сигнала и имеющее высокую плотность упаковки электрически соединенных элементов (или элементов и компонентов) и (или) кристаллов, которые с точки зрения требований к испытаниям, приемке, поставке и эксплуатации рассматриваются как единое целое, называется:
• интегральной микросхемой;
• микросхемой;
• микросборкой.
№ 6
Микроэлектронное изделие, в конструктивный состав которого входят:
- плата (или кристалл),
- элементы монтажа платы (или кристалла) в изделии;
- элементы электромонтажа платы (или кристалла) в изделии;
- элементы защиты платы (или кристалла),от внешних воздействий;
- элементы внешнего электромонтажа изделия,
называется:
• полупроводниковой микросхемой;
• микросхемой;
• микросборкой;
• тонкоплёночной микросхемой;
• толстоплёночной микросхемой;
• гибридной микросхемой.
№ 7
Кристалл (или плата), функциональное назначение которого изменяется изменением рисунка избирательных соединений, называется:
• базовый кристалл.
№ 8
Кристалл (или плата) с повторяющимися однородными группами соединённых (или не соединённых) функциональных элементов, функциональное назначение которого изменяется изменением рисунка избирательных соединений, называется:
• базовый кристалл;
• базовый матричный кристалл.
№ 9
Совокупность микросхем, выполняющих различные функции, имеющих единое конструктивно-технологическое исполнение, совместимых по электрическим параметрам и имеющих единые эксплуатационные показатели, называется:
• серия.
№ 10
Назовите признаки отнесения некоторых функциональных элементов конструкций микросхем к компонентам:
• исполнение их по собственным основным конструкторским документам;
• это изделия, специфицируемые в составе конструкций плат и микросхем.
№ 11
Чертеж масштабных изображений форм, размеров радиоэлементов, взаимного расположения границ областей кристалла (или платы), называется:
• топологическим чертежом;
• топологическим чертежом слоя.
№ 12
Чертеж масштабных изображений форм, размеров топологических областей, взаимного расположения границ областей слоя кристалла (или платы), предназначенный для снятия фотокопий, называется:
• оригиналом.
№ 13
Признаком классификации микросхем по технологии изготовления кристаллов и плат, учитываемым в построении обозначения микросхем, является:
• конструктивно–технологический способ исполнения.
№ 14
Признаком классификации микросхем, отражающим вид защиты кристаллов и плат от внешних воздействий и учитываемым в построении обозначения, является:
• конструктивное исполнение.
№ 15
Какие из перечисленных свойств микросхем отображаются в построении её обозначения?
• Функциональное назначение.
• Конструктивное исполнение.
• Конструктивно–технологический способ исполнения.
• Область применения.
№ 16
Укажите позиции, для которых номер позиции и наименование позиционируемого объекта соответствуют рисунку.
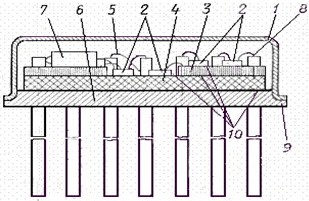
• 2. Компоненты.
• 5. Электромонтажный вывод.
• 8. Электромонтажное соединение.
• 9. Шов соединения основания и крышки корпуса.
• 10. Монтажные швы (связка).
№ 17
Укажите позиции, для которых номер позиции и наименование позиционируемого этапа проектирования микросхем соответствуют хронологической последовательности исполнения.
• 1. Техническое предложение.
• 3. Техническое проектирование.
• 5. Проектирование рабочей документации серийного производства.
• 6. Проектирование рабочей документации массового производства.
№ 18
Совокупность отличающихся геометрическими и электрическими параметрами слоёв поперечного сечения приповерхностной (до 10-20 мкм в глубину) области кристалла, соединённых и подключённых с целью придания им функциональных свойств электрорадиоэлементов электрических схем, называется:
• структурой элементов полупроводниковой микросхемы;
• рабочим набором слоев кристалла для исполнения на их основе электрорадиоэлементов и соединительных проводных связей микросхем.
№ 19
Плоскостные (двухмерные) размерные формы на поверхностности и приповерхностных слоях кристалла, электрически объединённые с целью придания им функциональных свойств одиночных электрорадиоэлементов электрических схем (или совокупностей электрорадиоэлементов), называются:
• топологией элементов полупроводниковой микросхемы;
• топологическими объектами кристалла микросхемы.
№ 20
Структура биполярного транзистора полупроводниковых микросхем содержит не менее четырёх (включая несущее основание) разнородных по электрическим параметрам слоёв с целью:
• обеспечения электрической изоляции коллекторной области транзистора от пассивной части кристалла.
№ 21
Удельная (на один квадратный миллиметр площади) ёмкость эмиттерного p-n-перехода кремниевой транзисторной структуры при ширине перехода 0,1 мкм, применённого в качестве конденсаторной структуры, равна:
• 1035. пФ/мм².
№ 22
В качестве резистора применена полоса базового слоя транзисторной структуры n-p-n типа. Эмиттерная область на полосе базового слоя не формировалась. В рабочем применении на концах резистора установились напряжения +0,24 и +1,78 В соответственно, относительно общего вывода (-Еп), соединённого с подложкой, однополярного источника питания Еп = 5 В. Удельная ёмкость изолирующего перехода при нулевом внешнем напряжении равна 2000 пф/мм². Определите среднее значение удельной емкости с учётом электрического смещения при корректном подключении коллекторного несущего кармана, корректном определении типа перехода и контактной разности потенциалов изолирующего перехода равной 0.7В.
• Соединение коллекторного кармана: с клеммой +5 В.
Тип перехода: плавный.
Среднее значение удельной емкости: 1030 пФ/мм².
№ 23
При семипозиционном обозначении материала, применяемого для производства пластин-подложек полупроводниковой технологии, укажите параметры, идентифицируемые пятой и шестой позициями обозначения:
• тип проводимости, материалы слитка и легирующей примеси, номинал удельного сопротивления и диффузионной длины.
№ 24
Комбинированной изоляции элементов кристаллов соответствует:
• повышенные рабочие напряжения и быстродействие элементов в сравнении и изоляцией p-n-переходом;
• снижение технологических потерь площади и брака в сравнении с диэлектрической изоляцией.
№ 25
Общая диффузия с учётом известных способов изоляции элементов может применяться в производстве биполярных микросхем в процессах формирования:
• коллекторных областей.
№ 26
Диффузия из ограниченного источника и соответствующий закон распределения примесей в слое в биполярной технологии применяются в формировании:
• коллекторных областей;
• скрытых слоях коллекторных областей;
• базовых областей;
• разделительных областей.
№ 27
Распределение N(x,t)=No*erfc(x/2*√(D)*t) соответствует профилю распределения примесей по глубине х:
• в результате процесса диффузии из неограниченного источника атомов примеси.
№ 28
Структура с наибольшим перераспределением примесей в эпитаксиальном слое в результате полной технологической обработки:
• структура с эпитаксиальным коллектором;
• структура с эпитаксиальным коллектором и скрытым слоем в коллекторе.
№ 29
Направления снижения уровня перераспределения примесей в эпитаксиальном слое.
• Выбор специализированных примесей для легирования.
• Повышение скорости наращивания эпитаксиального наращивания.
№ 30
Условия легирования технологических слоёв при формировании структуры БПТ тройной диффузией:
• коллекторный слой – ограниченный источник, базовый слой – ограниченный источник, эмиттерный слой – ограниченный источник, контактные области – неограниченный источник.
№ 31
- при формировании БПТ структуры ЭПСБ:
• коллекторный слой – ограниченный источник, коллекторный разделительный слой – ограниченный источник базовый слой – легирован квазиравномерно с перераспределением на границах при ограниченном источнике, эмиттерный слой – ограниченный источник, контактные области – неограниченный источник.
№ 32
- ЭПСК:
• коллекторный слой – легирован квазиравномерно с перераспределением на границах при ограниченном источнике, разделительный слой – ограниченный источник, базовый слой – легирован при ограниченном источнике, эмиттерный слой – ограниченный источник, контактные области – неограниченный источник.
№ 33
- ЭПСК со скрытым слоем в коллекторе:
• коллекторный слой – легирован квазиравномерно с перераспределением на границах при ограниченном источнике, разделительный слой – ограниченный источник, скрытый слой – при ограниченном источнике, базовый слой – легирован при ограниченном источнике, эмиттерный слой – ограниченный источник, контактные области – неограниченный источник.
№ 34
- КВД с дополнительным скрытым легированным слоем в коллекторе:
• коллекторный слой – легирован квазиравномерно с перераспределением на границах при ограниченном источнике, скрытый слой легирован при ограниченном источнике, базовый слой – легирован при ограниченном источнике, эмиттерный слой – ограниченный источник, контактные области – неограниченный источник;
• коллекторный слой – легирован равномерно с перераспределением на границах при ограниченном источнике, скрытый слой легирован квазиравномерно с перераспределением на границах при ограниченном источнике, базовый слой – легирован при ограниченном источнике, эмиттерный слой – ограниченный источник, контактные области – неограниченный источник.
№ 35
Какому из способов проектной оценки поверхностного сопротивления легированных полупроводниковых слоёв необходимы первичные сведения:
- тип материала;
- тип проводимости слоя;
- закон распределения примесей в слое;
- поверхностная концентрация примесей в слое;
- концентрация примесей до легирования в несущем слое;
- координаты границ легированного слоя;
- зависимости подвижности носителей заряда от концентрации.
• Аналитическому..
№ 36
Последовательность типов p-n-переходов структуры БПТ с технологией слоёв ЭПСБ в направлении от поверхности в глубину подложки.
• Квазирезкий, плавный, плавный.
№ 37
Электрическая прочность изолирующих промежутков и слоёв характеризуется напряжением их пробоя и не зависит от:
• свойств материалов изолируемых электродов.
№ 38
Напряжение лавинного пробоя резкого несимметричного p-n-перехода при слабо легированной n-области определяется по формуле:
• 86*ρn0.65(B);
Значение критической напряжённости в кремнии Екр составляет (2-5) 105 В/см.
№ 39
Допустимая плотность тока в направленно инжектирующем р-n-переходе определяется по:
• снижению эффективности направленной инжекции.
№ 40
Проектные функциональные параметры интегрального БПТ:
1. Номинальная электрическая прочность переходов, Upi,(B).
2. Номинальный рабочий ток БПТ, Ip,(mA).
3. Номинальный коэффициент передачи тока эмиттера, α.
4. Номинальное сопротивление БПТ, как открытого ключа, Rкл, (Ом).
5. Номинальное время переключения, Tпер,(сек).
№ 41
Рабочие напряжения БПТ ограничиваются:
• напряжениями пробоя переходов и коллекторной изоляции;
• выбором коэффициентов запаса к напряжениям пробоя;
• учётом коэффициентов умножения носителей в коллекторном переходе.
№ 42
Для проектного согласования рабочего тока БПТ с площадью его инжектирующего перехода необходимо:
• учитывать допустимую плотность тока в эмиттерном переходе.
№ 43
Для проектного выбора допустимого линейного размера длины эмиттера БПТ в направлении к контакту на базовой области необходимо:
• учитывать неравномерность плотности тока по инжектирующему переходу.
№ 44
Для проектного выбора допустимого линейного размера ширины эмиттера БПТ в направлении перпендикулярном направлению тока базы от эмиттера к контакту на базовой области необходимо:
• учитывать неравномерность плотности тока в подводящих проводниках эмиттерного перехода.
№ 45
При несоответствии допустимых линейных размеров эмиттера БПТ заданному рабочему току необходимо;
• применить многоэлектродные топологические конфигурации эмиттирующей области;
• проверить и, по возможности допустить, повышенную режимную плотность тока в эмиттере.
№ 46
Топологические формы и плоскостные размеры эмиттера и базы БПТ с вертикальной структурой:
• определяют влияние вклада боковой поверхности слоёв эмиттера и базы в потери переноса заряда от эмиттера к коллектору;
• снижают коэффициент передачи тока эмиттера в коллектор от значения, определяемого по структуре, по мере повышения площади эмиттера.
№ 47
При известной топологической форме и размерах эмиттера, топологические формы и размеры базовой и коллекторной областей определяют:
• выбирая форму и размеры контактов к коллектору по допустимому сопротивлению БПТ в открытом состоянии, согласуя их с формой и размерами базовой области, устанавливая зазоры между топологическими границами на коллекторной области руководствуясь технологическими допусками размеров;
• согласуя размещение, форму и размеры контактов к базе с формой и размерами эмиттера, устанавливая зазоры между топологическими границами на базовой области руководствуясь технологическими допусками размеров и влиянием продольного переноса в базе.
№ 48
Для удовлетворения требований к номинальному сопротивлению БПТ, как открытого ключа, выбором топологических форм и размеров, необходимо оценить соответствие требованиям по сопротивлению топологии БПТ, удовлетворяющей требованиям по рабочему току, и при несоответствии:
• модифицировать топологию БПТ, не уменьшая площади эмиттера, с образованием параллельных каналов для тока от эмиттера к коллекторным контактам;
• увеличить в допустимых пределах ширину эмиттера, скорректировать остальные топологические размеры и проверить соответствие требованию по сопротивлению.
№ 49
Для удовлетворения требований ко времени переключения БПТ выбором топологических форм и размеров необходимо:
• при неизменных размерах эмиттера увеличить число активных контактов к базе и коллектору;
• предельно до технологических норм сократить пассивные области топологии базы и коллектора.
№ 50
Структурные соединения слоёв n-p-n-БПТ структуры ЭПСБ для гальванически максимально “изолированных” от подложки диодов:
• Эмиттер-катод, база-коллектор-анод, подложка-общий вывод.
№ 51
Напряжение спрямления диода на основе коллекторно-базового перехода БПТ структуры ЭПСК при следующих исходных данных: полная площадь базы при неравномерности α1≤0.1 плотности тока по базе -200 мкм²; толщина нейтрального коллекторного слоя под базой – 3 мкм при поверхностном сопротивлении – 200 Ом; плотность тока насыщения инжектирующего перехода -10-910 A/см²; коэффициент не идеальности экспоненциальной модели m=1,2.
• 0,70 В.
№ 52
Рабочий ток диода на основе БПТ структуры «эмиттер-катод, база-коллектор-анод» при следующих исходных данных: полная площадь эмиттера при неравномерности α1≤0.1 плотности тока -200 мкм²; толщина нейтрального слоя базы под эмиттером – 1 мкм при поверхностном сопротивлении – 1500 Ом.
• 0.33 mА.
№ 53
Напряжение спрямления диода Шоттки при следующих исходных данных: полная площадь металлического контакта на n-кремнии (А=66А/см2°K2, контактный барьер – 0,65 В, Т=300°K2) -200 мкм²; рабочий ток диода α1≤1 мА.
• 0.36 В.
№ 54
Требования, которым должны соответствовать конструкции МЭТ для применения в качестве входных элементов схем ТТЛ.
• Топологическая симметрия эмиттеров относительно вывода базы.
• Коэффициент передачи тока эмиттера между смежными эмиттерами не более 0,1.
• Инверсный коэффициент передачи тока эмиттера не более 0,1.
№ 55
Актуальные требования, которым должны соответствовать конструкции многоколлекторных транзисторов (МКТ) для применения в качестве элементов интегральных цифровых схем.
• Близкие к равенству площадь базы и суммарная площадь коллекторов.
• Технологические структуры должны соответствовать повышению коэффициентов инжекции и переноса.
• Симметрия топологических областей коллекторов относительно инжектирующей области эмиттера.
№ 56
Соответствие свойств конструкциям транзисторов и барьером Шоттки (ТШ) для применения в качестве элементов цифровых схем.
• Ненасыщенный режим функционирования.
• Пониженное в сравнении с классическим исполнением БПТ время переключения.
№ 57
Требования, которым должны соответствовать конструкции биполярных транзисторов с продольной (торцевой) структурой (ТПС) для применения в качестве элементов цифровых интегральных схем.
• Площадь боковой поверхности структуры эмиттера, смежной с коллекторной областью, должна превышать площадь донной поверхности эмиттера.
№ 58
При исполнении двухвходового ТТЛ элемента без усилителя мощности с порогом срабатывания ≈2 0,6-0,7 В, с токозадающим резистором в базовой цепи многоэмиттерного транзистора (МЭТ) сопротивлением 2 кОм при источнике питания 3 В, оцените требуемую форму, необходимые размеры (а,b) и суммарную топологическую площадь эмиттеров (S) МЭТ, если допустимая плотность тока в эмиттере составляет 3 А/см²:
• Форма: квадратная;
Площадь: 100 мкм²;
Размеры: 7;7; мкм.
№ 59
Конструктивно корректная топология фрагмента переключающих БПТ трёхвходового ЭСЛ элемента на рисунке:
• 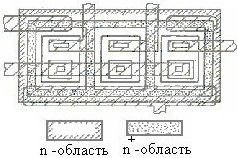
№ 60
При равных размерах, одинаковых формах, равных максимальных концентрациях примеси в слоях и типе проводимости и материале кристалла сопротивление резистора в базовом слое структуры ЭПСК превышает сопротивление в базовом слое структуры ЭПСБ:
• По причине разных законов распределения примесей.
№ 61
Состав вариантов конфигураций резисторов полупроводниковых микросхем с различиями:
• По форме и параметрам контактных областей: четыре варианта.
Наличием/отсутствием изгибов резистивной полосы: две расчётные формы изгибов.
Технологическим профилем изолирующих поверхностей: три варианта от технологии.
№ 62
Проектными функциональными параметрами резисторов полупроводниковых микросхем являются:
• рабочие напряжения изоляции резисторов;
• номинальное сопротивление;
• допустимый разброс сопротивления;
• выделяемая тепловая мощность.
№ 63
Укажите в группах исходных данных к проектированию конструкций полупроводниковых резисторов, корректные составляющие группы:
• Электрофизические параметры слоёв структуры конструкции: рабочие напряжения изоляции; поверхностные и переходные сопротивления; удельные ёмкости изоляции;
• Каталог форм и профилей, размеров технологических структур: толщины функциональных слоёв; формы профиля поверхностей;
• Функциональные параметры резистора: рабочие напряжения резисторов; номинальное сопротивление; допустимое разброс сопротивления;
• Каталог топологических форм конструкций резисторов: четыре варианта топологий;
• Технологические ограничения: производственные допуски размеров; производственные допуски электрофизических параметров слоёв; технологические нормы электрофизических параметров и параметров каталога структур;
• Совокупность расчётных соотношений и зависимостей: для связи размеров с номиналом; для связи размеров с производственным разбросом; для связи размеров с параметрами элементов частотно-временной модели; для связи размеров с параметрами теплового режима.
№ 64
Структуры конденсаторов полупроводниковых микросхем представлены:
• структурами полярных и квази неполярных конденсаторов;
• с числом диэлектрических слоёв более одного при двух рабочих обкладках;
• трёхэлектродными (трёхполюсными) структурами.
№ 65
Форма топологии активной площади конденсаторов полупроводниковых микросхем:
• влияет на производственную погрешность исполнения ёмкости;
• влияет на выбор расположения и направление выводов от обкладок.
№ 66
Параметрами функционального назначения конденсаторов полупроводниковых микросхем являются:
• номинальная ёмкость;
• два рабочих напряжения;
• относительный допуск ёмкости без учёта нелинейности емкости;
• добротность;
• отношение рабочей ёмкости к ёмкости изоляции.
№ 67
Проектная площадь конденсатора не зависит от рабочего напряжения; Емкость конденсатора не зависит от формы обкладок и расположения выводов от них.
№ 68
Структуры соединительных проводников кристаллов ИМС представлены:
• Слоями металлических плёнок: защитному диэлектрику с контактом к полупроводниковому слою в локальных областях.
• Диффузионными слоями: в качестве локальных диффузионных перемычек.
• Эпитаксиальными слоями: поликристаллических плёнок многослойных соединений в кристаллах МДП ИМС; локальными поликристаллических плёнок электродов элементов структур МДП.
№ 69
Тип проектного размера проводного соединения, определяемого по критериям:
• Соответствия ограничениям технологии: минимально-допустимый линейный размер топологии;
• Соответствия по тепловому режиму: ширина соединения;
• Соответствия по ограничениям на функциональные параметры соединения, как элемента электрических цепей: длина соединения.
№ 70
Параметры определяющие проектное значение порогового напряжения транзистора МДП ИМС:
• концентрация примесей в подложке под затвором;
• толщина подзатворного диэлектрика;
• ширина запрещённой зоны материала подложки;
• плотность встроенного заряда подзатворного диэлектрика;
• диэлектрическая проницаемость подзатворного диэлектрика;
• диэлектрическая проницаемость подложки;
• тип проводимости подложки.
№ 71
- прямое влияние на понижение сопротивления открытого транзистора МДП ИМС:
• ширина канала;
• толщина канала;
• подвижность носителей в канале;
• концентрация примеси в подложке.
№ 72
- прямое влияние на увеличение проектного значения крутизны транзистора МДП ИМС:
• Ширина канала.
• Подвижность носителей в канале.
• Диэлектрическая проницаемость диэлектрика затвора.
№ 73
- проектные значения рабочих напряжений транзисторов МДП ИМС:
• Толщина подзатворного диэлектрика.
• Параметры структуры перехода сток-подложка.
• Параметры материала подзатворного диэлектрика.
• Параметры материала подложки.
№ 74
- прямое влияние на снижение проектного значения времени переключения транзисторов МДП ИМС:
• Удельная ёмкость изоляции стока.
• Длина канала.
• Площадь стока.
№ 75
Укажите для вентиля МДП ИМС на транзисторах с одним типом канала корректное соотношение размеров каналов активного и нагрузочного транзисторов с учётом обозначений: L-длина канала, В-ширина канала, н-индекс нагрузочного транзистора, а-индекс активного транзистора.
• La<Lн, Ва=Вн.
• La=Lн, Ва>Вн.
• La<Lн, Ва>Вн.
№ 76
Коэффициент передачи прибора с зарядовой связью ПЗС определяется:
• потерями зарядового пакета при распространении от входа к выходу прибора;
• отношением размера зарядового пакета на выходе прибора к размеру пакета на входе в прибор;
• при фиксированной длине структуры и длительностью импульсов продвижения и размерами топологии элементов прибора.
№ 77
Положительные качества совмещённых БПТ и полевых приборов с управляемым p-n-переходом каналом для применения в конструкциях ИМС.
• Возможность снижения входных токов совмещённых приборов.
• Возможность создания инжекционно-полевого (ИПЛ) аналога И2Л со сходными ресурсами повышения степени интеграции.
№ 78
Время хранения состояния структуры ПЗС как регистра сдвига и памяти с последовательным доступом определяется:
• длительностью паузы между импульсами продвижения заряда и не зависит от длительности импульса продвижения.
№ 79
Утверждения по конструкциям, свойствам и управлению зарядовыми приборами на транзисторах с зарядовой связью (ТЗС).
• Топология и размеры электродов ТЭС отличаются один от другого, а в ПЗС одинаковы.
№ 80
Прибор c зарядовой связью на пожарных цепочках.
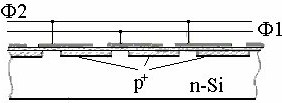
• ПЗС на “пожарных цепочках” не критичны к расстоянию между смежными элементами.
№ 81
Конструкции плат ГИМС.
• Температурное расширение материала плат оказывает негативное влияние на механическую прочность и стабильность параметров ГИМС при действии влаги.
№ 82
Конструкции тонкоплёночных резисторов ГИМС.
• Уменьшение толщины резистивного слоя и повышение через это номинала поверхностного сопротивления резистивной плёнки следует учитывать при согласовании размеров с технологическими допусками.
• Проектная площадь резистора увеличивается с уменьшением допуска на сопротивление, с уменьшением поверхностного сопротивления, и увеличением рабочего тока.
№ 83
Параметры конструкций толстоплёночных резисторов ГИМС.
• Конструкции этих резисторов следует исполнять в форме прямоугольных полос без изгибов.
• Технологическое рассеяние сопротивления толстоплёночных резисторов существенно превышает этот параметр тонкоплёночных резисторов.
№ 84
Параметры конструкций тонкоплёночных конденсаторов ГИМС.
• Число обкладок тонкоплёночных не превышает двух.
• Для повышения добротности конденсатора на заданной частоте следует уменьшать длину и увеличивать ширину его обкладок.
№ 85
Параметры конструкций толстоплёночных конденсаторов ГИМС.
• По добротности при прочих равных условиях конденсаторы сравнимы с тонкоплёночными конденсаторами.
№ 86
Параметры конструкций резисторов с подгонкой номинала ГИМС.
• Подгонка применяется для уменьшения площади резистора при заданной точности исполнения сопротивления резистора.
• Подгонка применяется для достижения заданной точности исполнения сопротивления резистора.
• Точность подгонки сопротивления определяется дискретностью элементов подгонки.
№ 87
Параметры конструкций плёночных катушек индуктивности ГИМС.
• Порядок величины индуктивности плоских катушек ГИМС: Единицы мкГн.
• Добротность плоских катушек повышается ферритовыми накладными фланцами.
• Проводящие поверхности в плоскости катушки снижают индуктивность.
№ 88
Конструкции пассивных компонент ГИМС.
• Компоненты пассивные применяются при технологическом несоответствии номинальных параметров, допусков параметров и размеров элементов.
• Форма, размеры, параметры, требования к монтажу, режимам и условиям применения компонент регламентируются согласованными в установленном порядке техническими условиями на изделия.
• Применение пассивных компонент к конструкциях ГИМС повышает вес технологических операций и маршрутов индивидуального монтажа изделий, в связи с чем: Повышаются затраты труда по производству изделий.
№ 89
Конструкции и применяемость активных компонент ГИМС.
• Прочие отличия в конструкциях активных компонент в сравнении с пассивными менее существенны, чем сходство конструкций по элементам монтажа и электромонтажа.
• Активные приборы применяются в качестве компонент ГИМС из-за несовместимости технологии их изготовления с технологией формирования плёночных структур.
• Отнесение к категории компонент ГИМС не связано с функциональной сложностью и степенью интеграции изделия с «активными» функциями.
№ 90
Конструкции СВЧ ИМС.
• В конструкциях СВЧ микросхем длительность фронтов сигнала приближается к длительности задержки распространения, вследствие конечных размеров элементов и их соединений, в диапазоне СВЧ.
• В соединениях микросхем с малыми потерями энергии для сигналов со сравнимыми длительностями фронтов и задержек распространения необходимо обеспечивать согласование нагрузки с размерами соединения.
• Понижение скорости распространения сигнала в теле элемента конструкции ИМС на фоне сохранения длительности его фронтов повышает влияние размеров конструкции на временные функциональные параметры элемента.
• Границы частот СВЧ диапазона выделены с учётом свойств отнесённых к распространению синусоидальных колебаний в вакууме.
№ 91
Степень интеграции ИМС это число, округлённое до целого в верхнюю сторону, равное:
• десятичному логарифму числа электрорадиоэлементов в конструкции изделия.
№ 92
Отнесение к категории больших интегральных микросхем (БИС):
• зависит от типа основного активного функционального электрорадиоэлемента;
• зависит от ''информационной ёмкости'' формы сигнала в активном элементе изделия с нелинейными характеристиками;
• производится по числу электрорадиоэлементов в изделии.
№ 93
В производстве и проектировании БИС имеют место:
• повышение вероятности отказа или брака всего кристалла при уменьшении размеров электрорадиоэлемента до значений, сравнимых с размерами дефектов на подложке;
• повышение вероятности попадания электрорадиоэлемента на дефект подложки и отказ (или брак) всего изделия при повышении габаритных размеров кристалла при фиксированной плотности дефектов на кристалле.
№ 94
Отличие перечня этапов проектирования кристаллов БИС от состава этапов проектирования кристаллов более низких степеней интеграции:
• имеется и связано с необходимостью специализации функций кристаллов БИС при разделении функционально сложного устройства на части без жёстких требований универсальности частей;
• имеется и связано с повышением объёма задач подсистем структурного и функционального уровня.
№ 95
Элементной базой кристаллов полузаказных цифровых БИС являются:
• однотипные топологические ячейки логических вентилей И/ИЛИ-НЕ с возможностью выбора ограниченного числа объединяемых входов, расположенные упорядоченно (матрично) относительно не подключённых шин питания и сигнальных шин;
• расположенные упорядоченно (матрично) относительно не подключённых шин питания и сигнальных шин топологические ячейки функциональных групп (триггеры, регистры, счетчики, полусумматоры, шифраторы и дешифраторы, мультиплексоры, усилители и др.) структурных единиц устройств.
№ 96
Библиотеки и каталоги топологий элементов, топологических ячеек с наборами не соединённых радиоэлементов, логических вентилей, функциональных групп, структурных единиц устройств позволяют:
• осуществлять компиляцию электрических схем структурного и функционального уровней представления в схемы принципиальные, расположения, соединения, подключения и в конструктивные структурно-топологические представления и документы;
• формализовать процесс проектирования схем и конструктивных объектов.
№ 97
Параметрами конструкции базового модуля кристалла БИС (ячейки) являются:
• нормированный линейный шаг в размещении и измерении конструктивных единиц ячейки;
• число и расположение, функциональное назначение выводов;
• плоскостные размеры ячейки.
№ 98
Какие из зон и областей на плане кристалла не обязательны.
• Тестовых элементов.
• Идентификационных указателей объектов внутреннего функционального состава кристалла.
№ 99
Какой из способов сокращения пассивной площади кристалла являются наименее эффективными?
• Выбор топологических конфигураций радиоэлементов с минимальным периметром при фиксированной площади элементов.
№ 100
Фигуры совмещения на кристалле предназначены для:
• контроля результатов исполнения слоёв в конструкции кристалла для разбраковки.
№ 101
Тепловой режим функциональных элементов кристаллов ИМС характеризуется:
• допустимой температурой элементов микросхемы;
• температурой окружающей среды;
• перегревом элементов относительно окружающей среды.
№ 102
Основные каналы искажения сигналов в кристаллах микросхем.
• Электрическое взаимодействие элементов кристалла.
• Линейные искажения сигналов в соединениях элементов и в элементах кристаллов.
№ 103
Снижение перегрева элементов кристаллов и плат относительно окружающей среды на уровне конструкции микросхемы обеспечивается:
• выбором монтажных материалов повышенной теплопроводности, расширением площади и уменьшением длины теплового канала от элементов и компонентов к поверхности корпуса.
№ 104
Механическая устойчивость конструкции ИС:
• повышается при снижении массы микросхемы;
• при установке эластичных прокладок между поверхностями, приклеивании, заполнении полостей компаундами, применении дополнительных точек крепления элементов конструкции.
№ 105
Каналы доступа агрессивных химических веществ к элементам конструкции микросхем, определяющим устойчивость и стабильность функциональных параметров микросхем:
• по стыкам соединений диэлектриков и металлов корпусных и защитных оболочек кристаллов и плат;
• поверхностное накопление вещества и электролиты между контактами вне корпусных и защитных оболочек микросхем;
• вместе с влагой через капилляры полимерных и керамических корпусных и защитных оболочек из внешней среды;
• из материалов защитных покрытий через химические взаимодействия с веществом функциональных элементов.
№ 106
Повышение устойчивости микросхем к действию агрессивных сред достигается:
• применением корпусных оболочек;
• защитными покрытиями;
• заполнением полостей корпусов нейтральным по химическому и электрофизическому влиянию на элементы плат и кристаллов веществом.
№ 107
Стандартами ЕСКД конструкторская документация определяется формами исполнения:
• как графическая;
• как текстовая.
№ 108
Стандартами ЕСКД конструкторская документация по назначению определяется:
• как проектная;
• как рабочая.
№ 109
- по характеру использования:
• как подлинники;
• как дубликаты;
• как копии.
№ 110
- по способу исполнения:
• как подлинники;
• как копии;
• как дубликаты.
№ 111
Основным документом кристалла микросхемы по определениям ЕСКД является:
• топологический чертёж.
№ 112
Масштабными конструкторскими документами микросхем являются:
• топологические чертежи;
• сборочные чертежи.
№ 113
Для корпусов микросхем стандарты вводят нормы:
• на форму корпуса;
• на расположение, форму и ориентацию выводов;
• на шаг и отступы от края корпуса выводов.
№ 114
В основной комплект электрических схем гибридной микросхемы включаются:
• электрические схемы микросхемы, как сборочной единицы.
| на главную | база по специальностям | база по дисциплинам | статьи |
Другие статьи по теме
